设置登录密码
*密码
*确认密码
完善信息
*真实姓名
*公司名称
*您的职位
城市
*邮箱
*主营产品
*行业
企业类型
材质
功能
2017-02-22




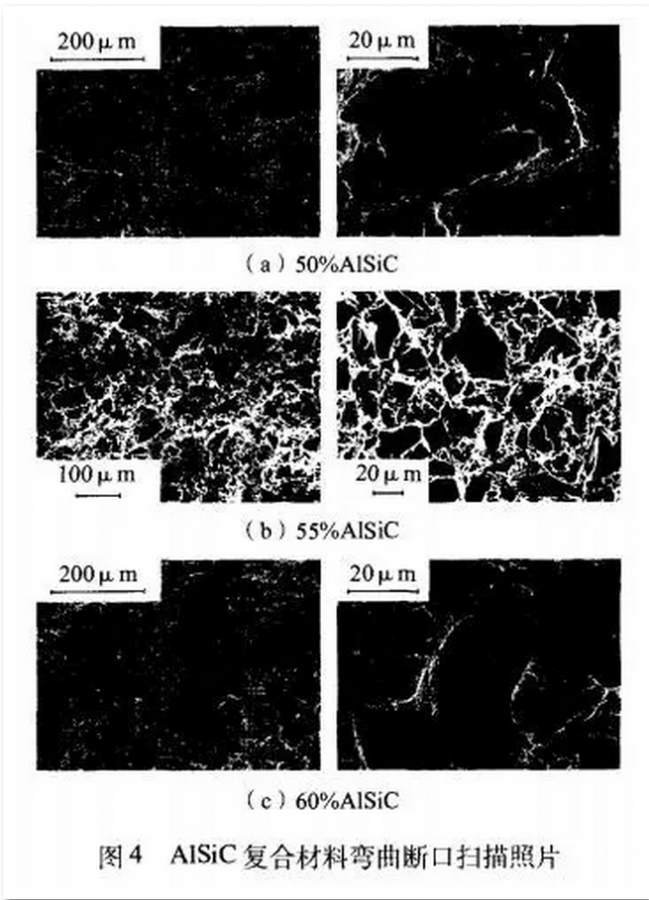

看新闻、读报告、找项目、约专家,尽在新材料在线APP
可在各大应用平台搜索 “新材料在线”